- Need to achieve miniaturization of module
- Need to achieve high speed at low cost
Compared to the method of bonding ICs on the PCB, FOWLP allows thinner designs by inserting a rewiring layer in the PCB layer.
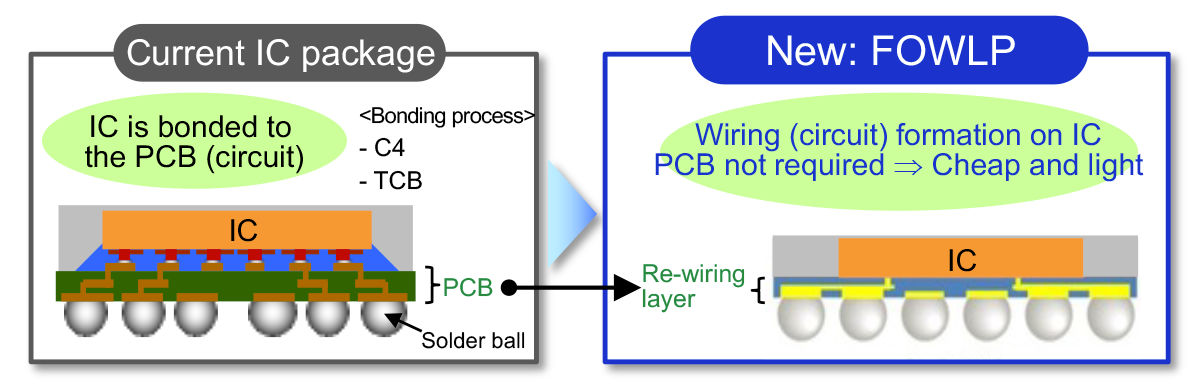

Bonder proposals in FOWLP
Flip-chip bonding method and die attach method are available.
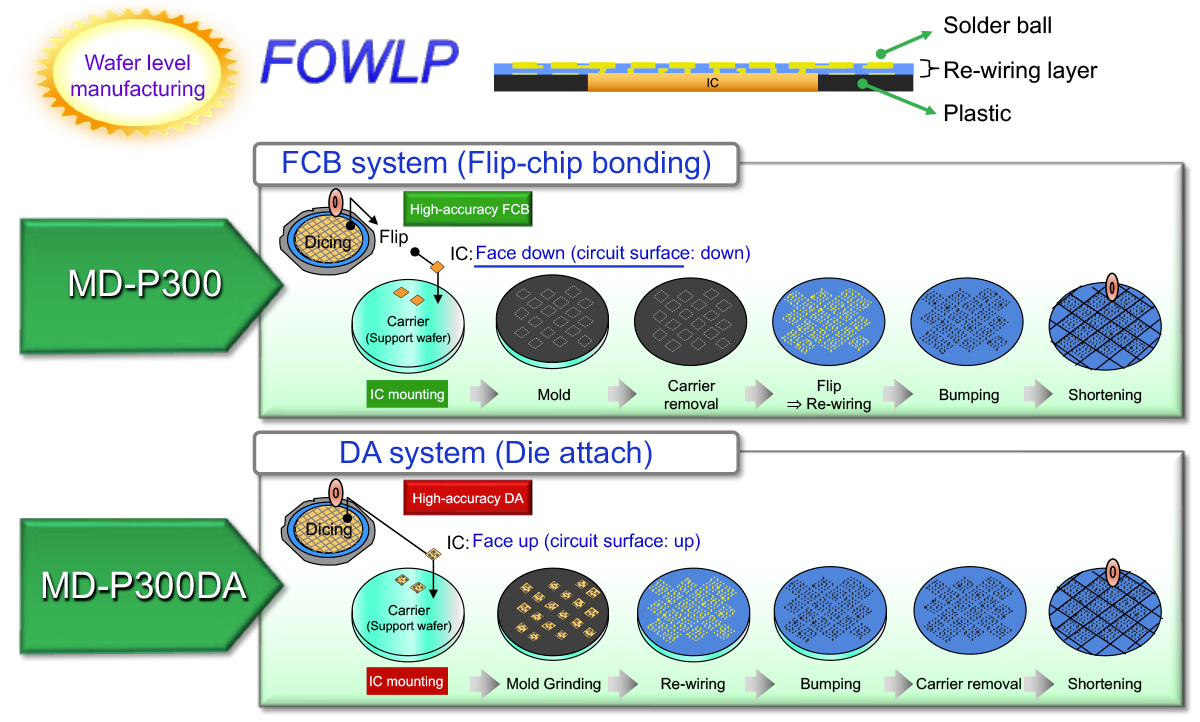
Flip-chip Bonder
MD-P300
Supports φ300 mm wafer supply. Realizes high-speed and high-accuracy flip-chip bonding applicable to COW bonding too.

Flip-chip bonding (Ultrasonic bonding)
In flip-chip bonding, which achieves miniaturization, Panasonic has especially honed its ultrasonic (US) bonding technology. The MD-P200US2 specially designed for the production of small devices (SAW-F, TCXO, etc.), contributes to customers’ production with its unique US monitoring function and the fastest bonding speed in the industry.
▲Difference in bonding methods
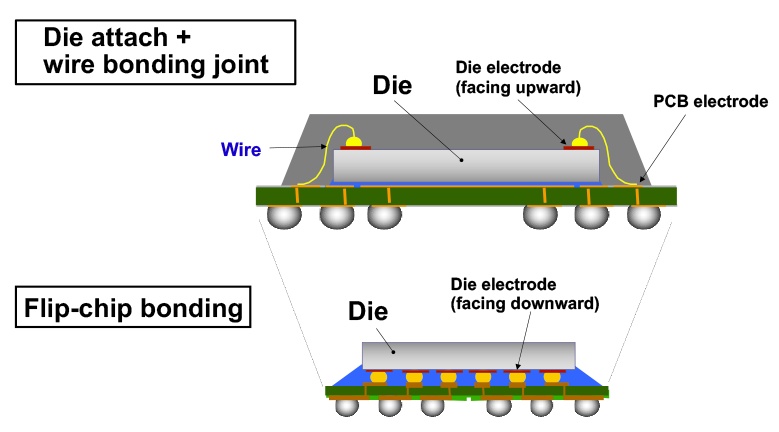
▲Bonding accuracy and productivity when ultrasonic (US) bonding is used
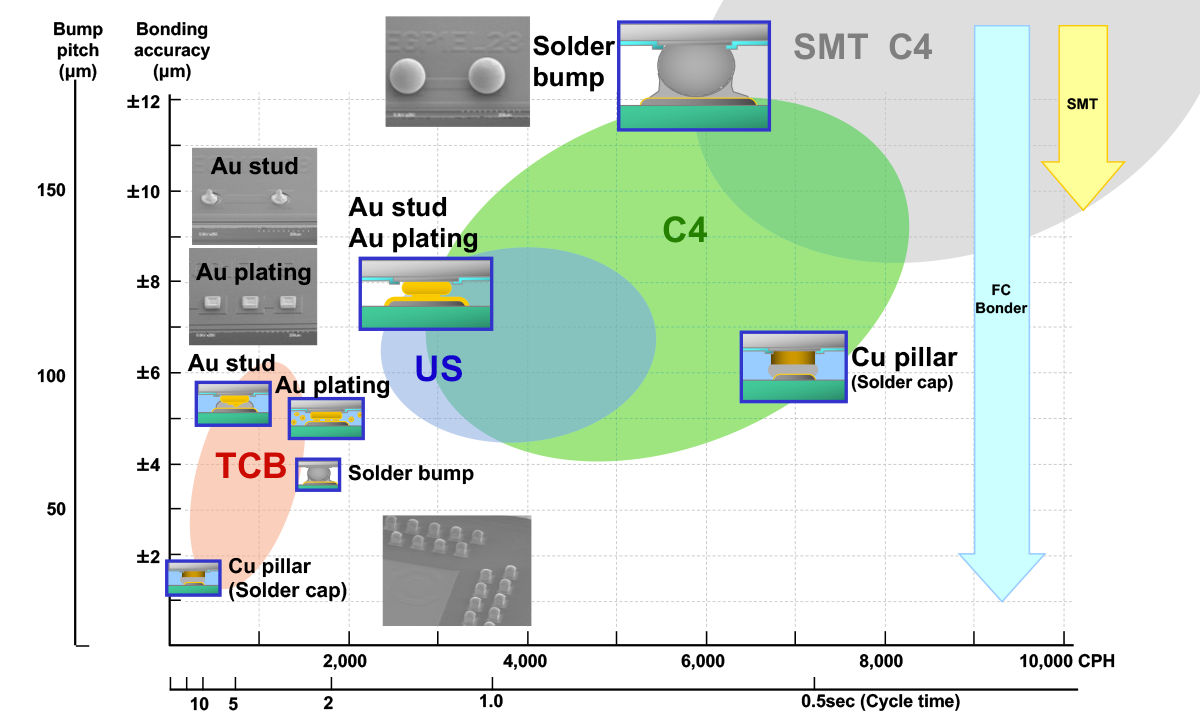
Die Bonder
MD-P200
Bonding device that is compatible with various bonding processes for state-of-the-art device assembly.

Flip-chip Bonder
MD-P200US2
Specialized ultrasonic flip-chip machine. Uses proprietary US tool and achieves a consistent quality.
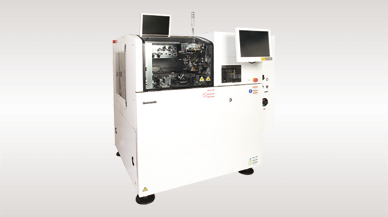
Supports various bonding processes
Compared to die bonding alone, this method achieves miniaturization, higher speed, and lower cost by supporting a variety of processes.
(1) Supports high-accuracy multi-die bonding
- Multi-die bonding of microchip dies in close adjacency on narrow pads contributes to module miniaturization
- Miniaturization contributes to cost reduction (base material, Au)
Die: Min 0.25 mm, Max 12 brands
Accuracy: DA; 15 μm/3σ
(2) Supports stack bonding
- Continuous stack bonding contributes to miniaturization of modules and lower cost by reducing intermediate heat treatment
- Miniaturization contributes to cost reduction (base material, Au)
Epoxy: Automatic switching of 2 brands
(3) Supports flip-chip bonding
- Contributes to miniaturization by less wire space
- Contributes to speeding up of processing by reducing wire length
- Contributes to cost reduction (Au→solder) by
C4 bonding
Accuracy: FC; ±7 μm/3σ
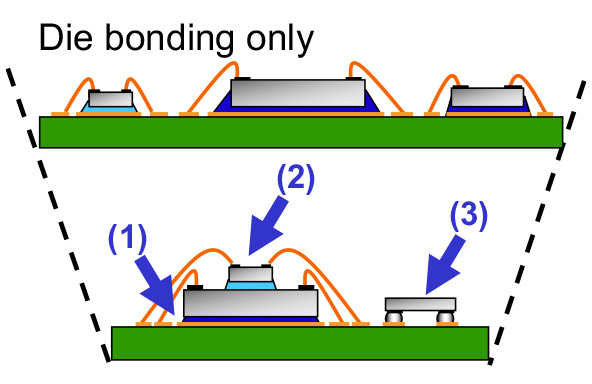
Die Bonder
MD-P200
Bonding device that is compatible with various bonding processes for state-of-the-art device assembly.
